京瓷低热膨胀陶瓷基板材料GL570助力IC芯片实现高性能低功耗
本文转自:中国网
随着5G的发展 , 高速处理大容量数据的需求不断增加 , 高性能计算机群(High Performance Computing , 简称HPC)作为高性能数据处理的解决方案 , 被各个领域的公司和组织使用 。
现在 , 高性能计算机群(HPC)器件的基板材料主要使用有机材料 , 但随着IC芯片Si转接板的大型化的推进 , 为了确保一次封装时以及一次封装后的可靠性 , 缩小与基板材料的热膨胀系数差异变得非常关键 。
京瓷开发的低热膨胀陶瓷基板材料GL570 , 热膨胀系数与Si接近 , 同时又具有高刚性 , 是适用于高性能计算机群(HPC)中大型化IC芯片或Si转接板的一次封装 , 且能确保可靠性的材料 。
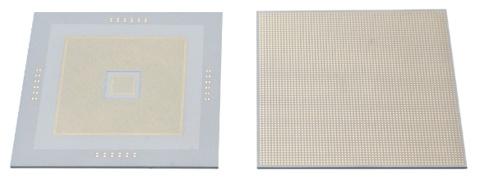
文章图片
文章图片
京瓷制GL570基板
高速处理大容量数据的高性能计算机群(HPC)器件 , 需要搭载多个高性能且低功耗的IC芯片 。业界正在开发Chiplet技术和2.5D封装技术 , 利用这些技术生产高性能计算机群(HPC)器件 , 以满足市场需求 。而为了实现多个IC芯片的高度集成 , 会考虑采用大型Si转接板的解决方案 。
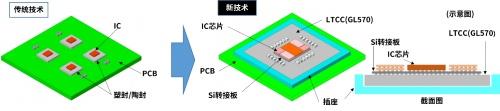
文章图片
文章图片
京瓷的低热膨胀陶瓷基板材料GL570 , 采用热膨胀系数和Si相近的材料 , 实现了低热膨胀 , 高刚性 , 因此非常适用于对应不断推进大型化的Si转接板 。

文章图片
文章图片
【京瓷低热膨胀陶瓷基板材料GL570助力IC芯片实现高性能低功耗】高刚性的陶瓷基板可以缓解一次封装时的热应力 , 同时抑制IC芯片转接板的形变 。除此之外 , 结合GL570的另一个特征——低热膨胀系数 , 可以实现更高水准的一次封装可靠性 。

文章图片
文章图片
京瓷还可以根据客户需求提供大型基板定制 , 大型单晶芯片和Si转接板以及周围零部件可一次性全部装配在基板上 。
- 苹果投资商用纯度低碳铝 将在iPhone SE率先使用
- 2022年中国低代码行业生态发展洞察报告发布,低代码生态圈或成未来趋势
- 回顾:复亚智能无人机自动机场高低温测试及结露测试
- 王者荣耀联动86版西游记|王者荣耀联动86版西游记(公孙离玉兔公主皮肤,活动最低价格532点券)
- NVIDIA连发七款新卡:最高摸到3080Ti、最低阉割没法看
- 25款加湿器实测!“戴森”“飞利浦”“小熊”加湿效率较低
- amdrx6500xt欧洲售价低于建议零售价
- nvidia低调发布七款rtxa系列工作站显卡
- 小米产品经理:civi轻薄好手感一直被低估
- AMD YES归来!16核旗舰锐龙9 5950X跌至史低价
