研究揭示空间充放电诱发星用电路“非单粒子软错误”机制
国内外的空间飞行实践发现 , 空间环境通过单粒子(SEE)和充放电(SESD)两种方式导致较多的航天器故障 , 且均主要为星用电子设备出现数据或逻辑状态跳变、工作模式非受控切换、执行机构操作异常等可恢复性“软错误”故障 。长期以来 , 学术界和工程界将二者分割开来研究、应用 , 对二者诱发航天器故障宏观现象上的关联与区别、二者微观作用机制上的异同不甚了解 , 即对二者的认识混淆不清 , 将大量的此类“软错误”故障简单地归为单粒子所致 。这种现状对数量较多既遭受单粒子又遭受充放电作用的中高轨航天器造成隐患 , 如何及时正确诊断在轨由空间环境诱发故障的原因 , 如何全面准确评估研发中的航天器面临的两类“似同非同”的空间环境风险 , 如何针对这两类空间环境危害开展“无死角”的综合防护设计工作 , 是困惑国内外航天界的难题 。
中国科学院国家空间科学中心复杂航天系统电子信息技术院重点实验室副研究员陈睿、研究员韩建伟团队 , 以典型星用SRAM存储电路和运放线性电路为例 , 首次揭示了单粒子和充放电两种空间辐射效应导致星用电路“软错误”的特征规律、敏感区域以及损伤机制的关联性与区别 , 为厘清二者诱发星用电子器件错误和设备故障的异同规律及机理、建立全面评估风险、正确防护设计和准确诊断在轨故障的技术方法提供重要参考和理论支持 。
研究工作得到国家自然科学基金青年科学基金、面上项目 , 以及中科院复杂航天系统电子信息技术重点实验室基金的资助 。相关研究成果发表在IEEE Transactions on Device and Materials Reliability和Electronics上 。
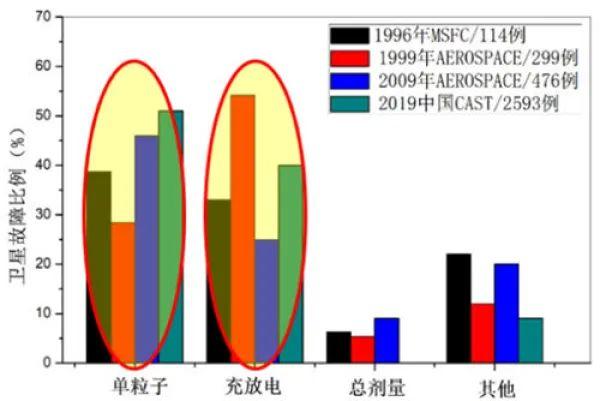
文章图片
文章图片
图1.空间环境通过不同方式诱发在轨卫星故障的比例

文章图片
文章图片
图2.SEE与SESD作用SRAM电路(上)和运放电路(下)的原理过程

文章图片
文章图片
图3.SEE(上)和SESD(下)作用致SRAM错误数与错误类型
【研究揭示空间充放电诱发星用电路“非单粒子软错误”机制】
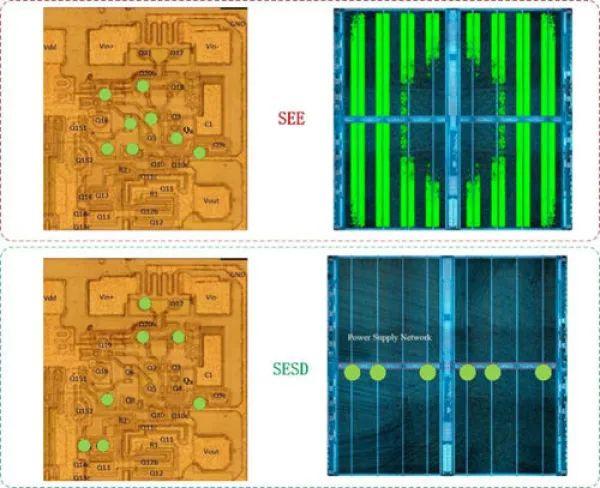
文章图片
文章图片
图4.SRAM(左)和运放(右)的辐射薄弱区域:SEE敏感区域(上)和SESD敏感区域(下)
来源:中国科学院国家空间科学中心
来源:中科院之声
- 和数研究院被授予首批苏州工业园区“区块链重点企业”
- 中国信息研究院:国内市场手机出货量3340.1万部,同比增长25.6%
- 我国首次实现低轨宽带卫星批产;研究称奥密克戎在陶瓷表面存活时间最短丨科技早新闻
- 研究者发现了一种或能引发更强大的基因编辑方法
- 上海咖啡文化再添新空间:星巴克1971客厅、专星送新功能等首发美团
- 首发美团 星巴克推1971客厅专属空间服务
- 蓝相液晶光子晶体的高精度“活”图案制备研究获进展
- 云顶之弈12.1研究生永恩阵容怎么选(云顶之弈12.1研究生永恩阵容组合心得分享)
- 以数字创新焕新第三空间 星巴克1971客厅等新功能在美团首发
- 星巴克全面上线美团外卖 深圳等地可线上预订专属空间服务
