Apple M1 Ultra 芯片互连背后的技术

文章图片
文章图片
如今 , 构建高性能微处理器变得越来越棘手 , 成本也越来越高 , 这就是为什么开发人员必须选择复杂的封装技术以及针对性能要求高的应用程序的设计 。苹果承认 , 要制造其M1Ultra处理器 , 它必须将两个M1Max系统级芯片融合在一起 , 但它没有说它必须使用台积电最先进的封装技术之一来制造M1Ultra 。
幸运的是 , 非官方消息来源没有苹果那么神秘 , 并且能够挖掘出有关苹果UltraFusion处理器间互连的更多细节 , 该处理器提供2.5TB/s的带宽 。有媒体报道称 , Apple的M1Ultra处理器使用TSMC的CoWoS-S(带有硅中介层的芯片上晶圆基板)基于2.5D中介层的封装工艺来构建M1Ultra 。AMD、Nvidia和富士通等公司使用类似的技术来构建用于数据中心和高性能计算(HPC)的高性能处理器 。
【Apple M1 Ultra 芯片互连背后的技术】Apple的M1Ultra无疑是一个强大的设计 。每个M1MaxSoC的裸片尺寸为432mm2 , 因此M1Ultra使用的中介层必须超过860mm2 。这是相当大的 , 但并非闻所未闻 。AMD和Nvidia使用更大的中介层 , 其计算GPU具有高带宽内存 。
我们不知道如何称呼M1Ultra 。从技术上讲 , 这是一个系统级芯片封装 , 或SoCIP , 但这可能有点拗口 , 所以我们现在称它为“处理器” 。
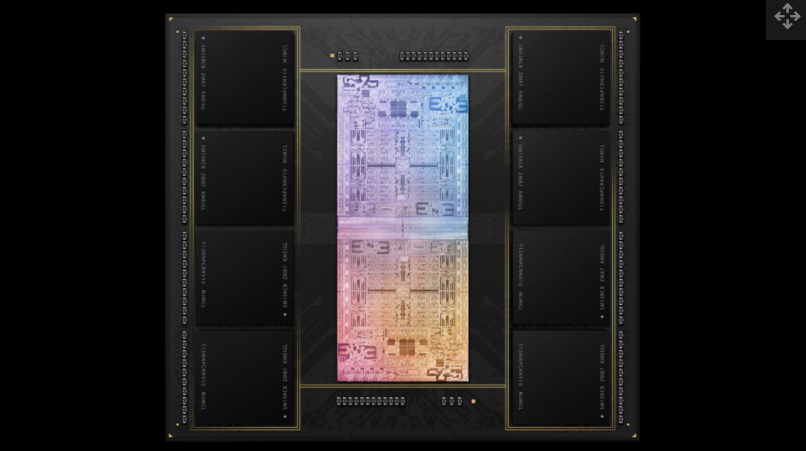
文章图片
文章图片
但台积电的CoWoS-S并不是这家全球最大的半导体制造商在带宽密集型应用中的唯一选择 。一些专家推测 , 苹果可能会选择台积电的InFO_LSI技术进行超高带宽小芯片集成 。与CoWoS-S不同 , InFO_LSI使用局部硅互连而不是大型且昂贵的中介层 。英特尔的嵌入式芯片互连桥(EMIB)使用相同的概念 。
请记住 , Apple展示了带有大型I/O焊盘的M1Maxdieshot , 类似于旨在连接到中间芯片的本地互连 , 因此许多人认为Apple使用了InFO_LSI也就不足为奇了 。
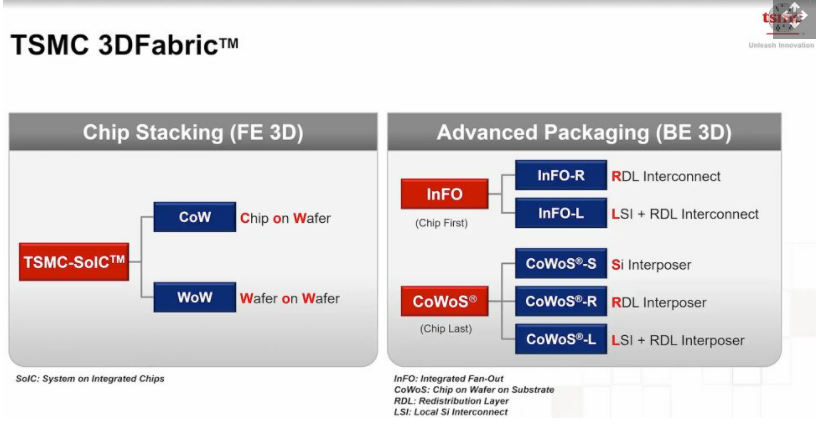
文章图片
文章图片
但苹果可能坚持使用可能更昂贵的CoWoS-S是有原因的 。台积电的InFO_LSI于2020年8月正式推出 , 原定于2021年Q1完成认证 。与此同时 , Apple的M1Max将于2021年Q2或Q3进入量产 , 因此苹果可能根本没有足够的时间实现InFO_LSI 。或者它决定不冒险并坚持使用各种公司广泛使用的知名技术 。
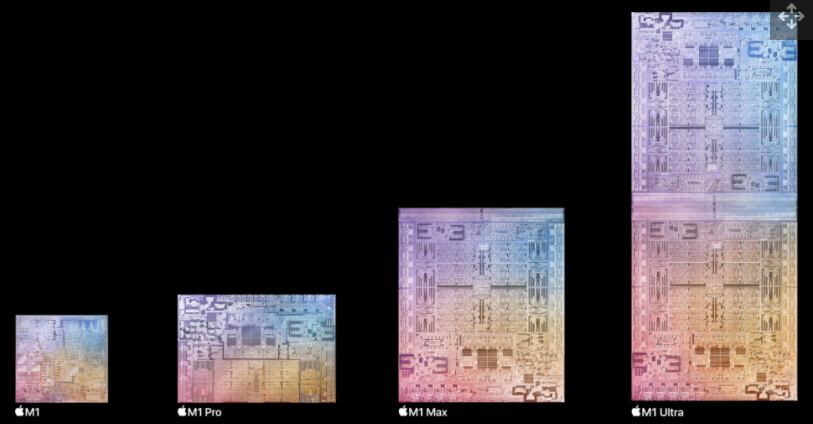
文章图片
文章图片
DigiTimes披露的另一件事是 , UnimicronTechnology现在是苹果唯一的ABF基板供应商 , 因为它是唯一一家能够提供苹果需要的质量和数量的公司 。无论如何 , 虽然我们现在知道Apple使用什么封装技术来实现其UltraFusion互连 , 但我们仍然不知道它的时钟、总线宽度、功率等 , 所以请继续关注 。
*免责声明:本文由作者原创 。文章内容系作者个人观点 , 半导体行业观察转载仅为了传达一种不同的观点 , 不代表半导体行业观察对该观点赞同或支持 , 如果有任何异议 , 欢迎联系半导体行业观察 。
- 小米顶级旗舰12 Ultra曝光:可能用索尼传感
- 全球首发天玑8100芯片redmibookpro发布
- 无可撼动的安卓机皇!三星S22 Ultra评测
- 苹果官网上架新款applewatch春季表带
- 首发自研芯片!OPPO Find X5 Pro成了
- M1 Ultra拳打Intel脚踢AMD/NV 网友心塞
- 国区Apple Music开启优惠活动:10元可畅听3个月
- 苹果m1ultrafusion封装技术解析
- apple store无法连接是怎么回事(apple store无法连接原因详细说明)
- 小米12ultra将接替小米11ultra,可能是索尼传感器
