苹果m1ultrafusion封装架构解析( 二 )
第二项就是互连功耗控制 , UltraFusion使用可关闭的缓冲器(Buffuer) , 进行互连缓冲器的功耗控制 , 有效降低暂停的互连线的能耗 。
第三项是优化高纵横比的硅通孔(TSV) , TSV是硅中介层技术中另一个非常关键部分 。UltraFusion/CoWoS-S5通过使用重新设计的TSV , 优化传输特性 , 以适合高速SerDes传输 。
第四项集成在中介层的电容(iCAP) , UltraFusion在中介层集成深沟槽电容器(iCap) , 提升芯片的电源完整性 。集成在中介层的电容密度超过300nF/mm2 , 帮助各芯粒和信号互连享有更稳定的供电 。
第五项新的热界面材料 , UltraFusion通过集成在CoWoS-S5中 , 使用热导率>20W/K的新型非凝胶型热界面材料(TIM) , 拥有100%的覆盖率 , 提高各个高算力芯粒的散热能力 , 提升整体散热性能 , 降低积热 。
第六项通过Die-Stitching技术有效提升封装良率降低成本 , UltraFusion仅将KGD(KnownGoodDie)进行键合 , 避免传统WoW(WaferonWafer)或CoW(ChiponWafer)中失效的芯粒被封装的问题 , 提升封装后的良率 , 降低整体的平均成本 。
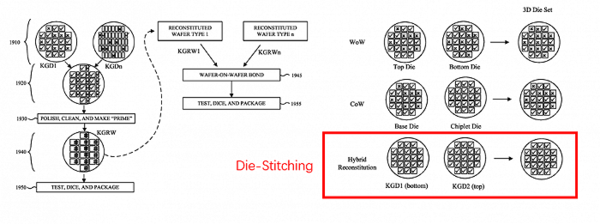
文章图片
文章图片
编辑点评:苹果的UltraFusion技术充分结合封装互连技术、半导体制造和电路设计技术 , 为整合面积更大、性能更高的算力芯片提供巨大的想象空间 。同时 , M1Ultra的成功 , 会让传统的芯片制造商 , 感受到更大的压力 。
作为未来半导体的发展方向 , 先进封装技术在最近几年已得到广泛的应用 , 同时获得大众的认可 。特别是越来越多厂商加入到自研芯片的大军 , 如何提升Chiplet之间的互联、再到与HBM或DDR内存之间的带宽 , 也是延续摩尔定律的焦点 。

文章图片
文章图片
- 苹果开始销售官方翻新版 iPhone 12 和 12 Pro
- 苹果iphonese3发货延期至3月24日至31日
- 苹果“雷电数据线”为什么要卖到1000元吗
- 苹果ios15.4更新,这些新功能你都知道吗?
- 苹果12怎么进入双卡模式(苹果12设置双卡使用教程)
- 苹果 iPhone 14系列最新爆料:将提供四种型号,卫星功能仍可期待
- 苹果手机隔空投送怎么搜不到对方(苹果手机隔空投送搜不到对方处理步骤)
- 苹果手机隔空投送失败怎么回事(苹果手机隔空投送失败原因详解)
- 苹果手机隔空投怎么改送名字(苹果手机隔空投送名字修改教程)
- 苹果手机隔空投送如何打开(苹果手机隔空投送开启教程介绍)
