划片机:晶圆加工第四篇—刻蚀的两种方法
刻蚀
在晶圆上完成电路图的光刻后 , 就要用刻蚀工艺来去除任何多余的氧化膜且只留下半导体电路图 。要做到这一点需要利用液体、气体或等离子体来去除选定的多余部分 。
【划片机:晶圆加工第四篇—刻蚀的两种方法】刻蚀的方法主要分为两种 , 取决于所使用的物质:使用特定的化学溶液进行化学反应来去除氧化膜的湿法刻蚀 , 以及使用气体或等离子体的干法刻蚀 。
1、湿法刻蚀
使用化学溶液去除氧化膜的湿法刻蚀具有成本低、刻蚀速度快和生产率高的优势 。然而 , 湿法刻蚀具有各向同性的特点 , 及其速度在任何方向上都是相同的 。这会导致掩膜(或敏感膜)与刻蚀后的氧化膜不能完全对齐 , 因此很难处理非常精细的电路图 。
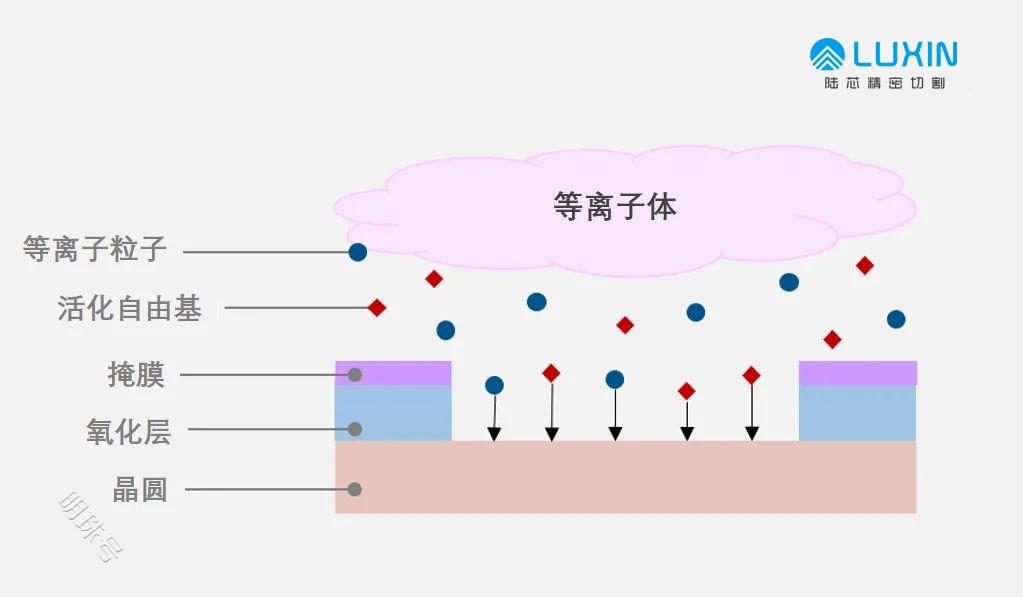
文章图片
文章图片
2、干法刻蚀
干法刻蚀可分为三种不同类型 。
1)化学刻蚀 ,
其使用的是刻蚀气体(主要是氟化氢) 。和湿法刻蚀一样 , 这种方法也是各向同性的 , 这意味着它也不适合用于精细的刻蚀 。
2)物理溅射
即用等离子体中的离子来撞击并去除多余的氧化层 。作为一种各向异性的刻蚀方法 , 溅射刻蚀在水平和垂直方向的刻蚀速度是不同的 , 因此它的精细度也要超过化学刻蚀 。但这种方法的缺点是刻蚀速度较慢 , 因为它完全依赖于离子碰撞引起的物理反应 。
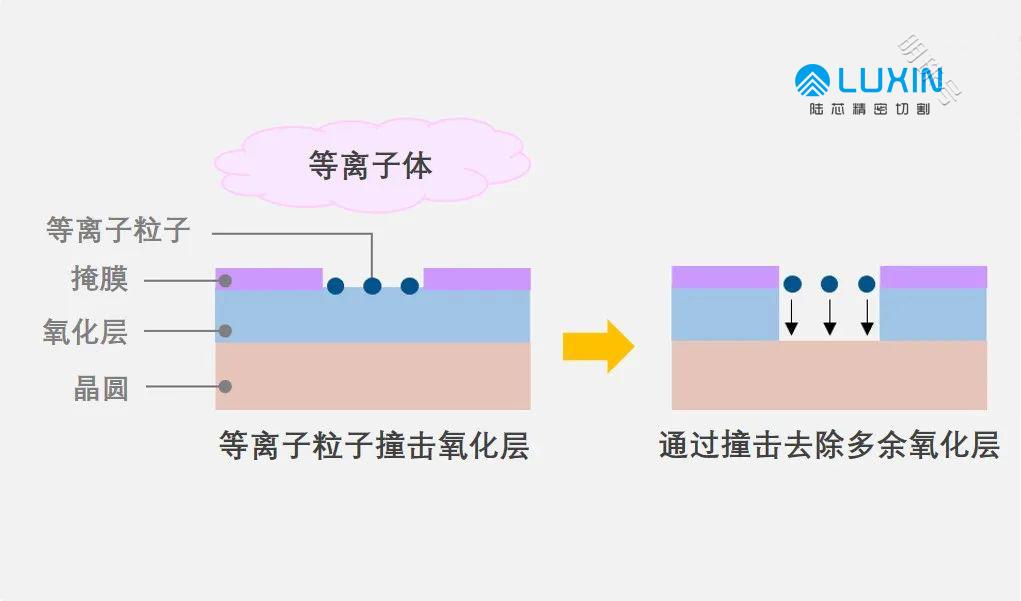
文章图片
文章图片
3)反应离子刻蚀(RIE)
RIE结合了前两种方法 , 即在利用等离子体进行电离物理刻蚀的同时 , 借助等离子体活化后产生的自由基进行化学刻蚀 。除了刻蚀速度超过前两种方法以外 , RIE可以利用离子各向异性的特性 , 实现高精细度图案的刻蚀 。
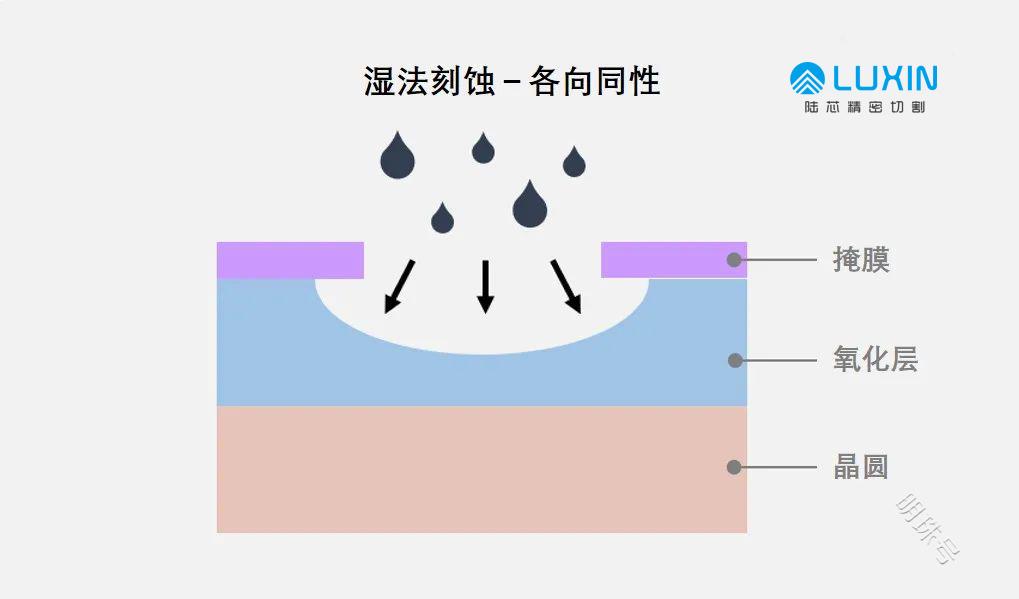
文章图片
文章图片
如今干法刻蚀已经被广泛使用 , 以提高精细半导体电路的良率 。保持全晶圆刻蚀的均匀性并提高刻蚀速度至关重要 , 当今最先进的干法刻蚀设备正在以更高的性能 , 支持最为先进的逻辑和存储芯片的生产 。
- 划片机:晶圆加工第二篇—关于晶圆氧化过程,这些变量会影响它的
- 华中佳味咸宁预制菜加工基地投产,温氏佳味品牌迎来大升级
- 划片机:晶圆加工第一篇—所有半导体工艺都始于一粒沙子!
- 钣金机柜加工的常用工艺有哪几种?
- 如何控制钣金机箱加工的质量?
- 【陆芯半导体】精密划片机在钽酸锂晶圆切割案例
- 忠艺隆五金|提高钣金加工生产效率的方法
- 长江存储第二座晶圆厂年底投产产能有望提升至30万片
- 钣金外壳加工对于材料有哪些要求?-忠艺隆五金
- 钣金加工如何选择折弯系数?
